
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ЕТЦХИНГ ВАФЕР ЦАРРИЕР
Семицорек Ектинг Вафер Носач са ЦВД СИЦ премазом је напредно, високо-перформанси решење прилагођено захтјев за захтевне апликације за структори за полуводиче. Његова супериорна топлотна стабилност, хемијска отпорност и механичка издржљивост чине је суштинском компонентом у модерном фабрику вафла, обезбеђујући високу ефикасност, поузданост и економичност за произвођаче полуводича широм света. *
Пошаљи упит
Семицорек Етцхинг Вафер Царриер је платформа за подршку супстрат високих перформанси дизајнирана за процесе израде полуводича, посебно за апликације за резање. Инжењерирани са високим чистоћи графитним базом и пресвуже се са хемијским таложењем паре (ЦВД) Силиконским карбидом (СИЦ), овај носач од вафера пружа изузетну хемијску отпорност, топлотну стабилност и механичку издржљивост, обезбеђујући оптималне перформансе у окружењу високо прецизности.
Носач јеткање плоча је обложен униформним ЦВД СИЦ слојем, што значајно повећава његову хемијску отпорност на агресивне плазме и корозивне гасове који се користе у процесу јеткања. ЦВД је главна технологија за припрему СИЦ премаза на површини супстрата тренутно. Главни процес је да се сировина сировина фаза гасне фазе пролазе низ физичких и хемијских реакција на површини подлоге и коначно депоновање на површини подлоге да припреми СИЦ премаз. СИЦ премаз који је припремила ЦВД технологија уско је везана на површину подлоге, што ефикасно побољшава отпорност на оксидацију и отпорност на аблацију супстрата, али време одлагања ове методе је дугачак, а реакциони гас садржи одређене токсичне гасове.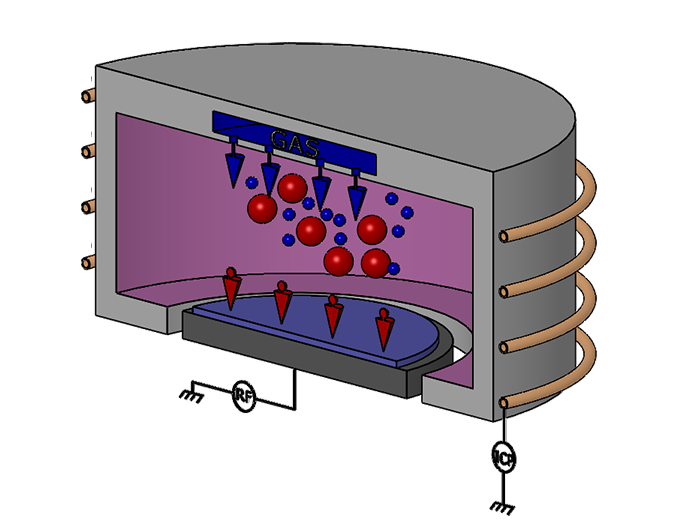
ЦВД СИЛИЦОН ЦАРБИДЕ ЦОАТИНГДелови се широко користе у Ектинској опреми, моцвд опреми, СИ епитаксалну опрему и СИЦ епитаксајску опрему, брзу опрему за топлотну обраду и другим пољима. Све у свему, највећи сегмент тржишта ЦВД дијелова за прекривање силицијума карбида је јединица за етцхинг и делови епитаксија. Због ниске реактивности и проводљивости ЦВД Силицон Царбиде Цоатион-а на гасове који садржи и флуорински који садрже, постаје идеалан материјал за фокусирање прстенова и осталих делова машине за јеткање плазме.ЦВД СИЦ деловиУ ЕТЦХИНГ опреми укључујуфокусирање прстенова, Главе за туширање гаса, ладице,прстенови ивица, итд. Узмите прстен у фокусу као пример. Прстен за фокусирање је важна компонента која се налази изван резине и директан контакт са вафром. Напон се наноси на прстен за фокусирање плазме која пролази кроз прстен, чиме се фокусира на плазми на резину како би побољшала униформност обраде. Традиционални фокусирани прстенови су направљени од силицијума или кварца. Унапређењем интегрисане минијатуризације круга, потражња и значај процеса јеткања у интегрисаној изради круга, а снага и енергија јеткање плазме и даље се повећавају.
СИЦ премаз нуди врхунски отпор против флуоринских (Ф₂) и хемијских филмова на бази хлора (ЦЛ₂), спречавајући деградацију и одржавање структурног интегритета током продужене употребе. Ова хемијска робусност осигурава доследне перформансе и смањује ризике за контаминацију током прераде вафла. Превозник од вафера може се прилагодити различитим величинама вафла (нпр. 200 мм, 300 мм) и специфичних потреба за стручним системом. Прилагођени дизајни и обрасци рупа доступни су за оптимизацију позиционирања вафла, контрола протока гаса и ефикасност процесе.
Апликације и користи
Носач за етцхинг вафер се првенствено користи у производњи полуводича за процесе сувог јеткања, укључујући и јеткање плазме (ПЕ), реактивно јонско ионско ион (рие) и дубоко реактивно јонско ион. Широко је усвојена у производњи интегрисаних кругова (ИЦС), МЕМС уређаја, електронике за напајање и једињени полуводички вафери. Његов робусни СИЦ премаз осигурава доследне резултате јеткања спречавањем разградње материјала. Комбинација графита и СИЦ-а пружа дугорочну трајност, смањење трошкова одржавања и замјене. Глатка и густа површина СИЦ минимизира стварање честица, обезбеђивање високог приноса високе стране и врхунске перформансе уређаја. Изузетна отпорност на оштре окружења за етцхинг смањује потребу за честим замјенама, побољшање ефикасности производње.













