
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
СиГе у производњи чипова: Извештај о професионалним вестима
Еволуција полупроводничких материјала
У домену модерне полупроводничке технологије, немилосрдна тежња ка минијатуризацији померила је границе традиционалних материјала на бази силицијума. Да би испунио захтеве за високим перформансама и малом потрошњом енергије, СиГе (силицијум германијум) се појавио као композитни материјал избора у производњи полупроводничких чипова због својих јединствених физичких и електричних својстава. Овај чланак се бавипроцес епитаксијеСиГе и његова улога у епитаксијалном расту, напрегнутим апликацијама силицијума и Гате-Алл-Ароунд (ГАА) структурама.
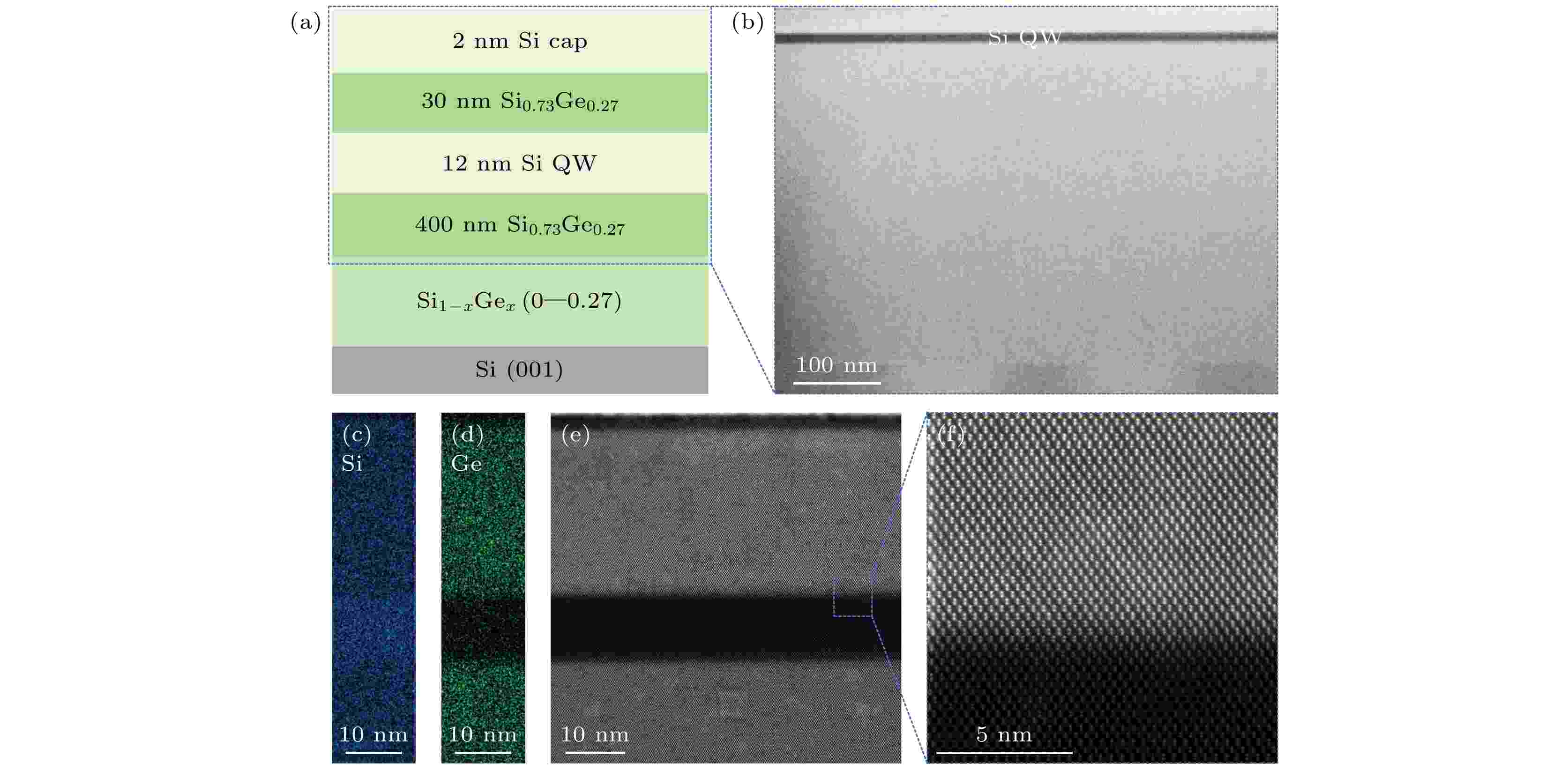
Значај СиГе епитаксије
1.1 Увод у епитаксију у производњи чипова:
Епитаксија, често скраћена као Епи, односи се на раст монокристалног слоја на монокристалној подлози са истим распоредом решетке. Овај слој може бити било којихомоепитаксијални (као што је Си/Си)или хетероепитаксијални (као што су СиГе/Си или СиЦ/Си). За епитаксијални раст се користе различите методе, укључујући епитаксију молекуларним снопом (МБЕ), ултра-високо вакуумско хемијско таложење паре (УХВ/ЦВД), атмосферску епитаксију и епитаксију сниженог притиска (АТМ & РП Епи). Овај чланак се фокусира на процесе епитаксије силицијума (Си) и силицијум-германијума (СиГе) који се широко користе у производњи полупроводничких интегрисаних кола са силицијумом као материјалом супстрата.
1.2 Предности СиГе епитаксије:
Укључивање одређене пропорције германијума (Ге) токомпроцес епитаксијеформира СиГе монокристални слој који не само да смањује ширину појасног размака већ и повећава граничну фреквенцију транзистора (фТ). Ово га чини широко применљивим у високофреквентним уређајима за бежичне и оптичке комуникације. Штавише, у напредним процесима ЦМОС интегрисаних кола, неусклађеност решетке (око 4%) између Ге и Си доводи до напрезања решетке, повећавајући мобилност електрона или рупа и на тај начин повећавајући струју засићења уређаја и брзину одзива.
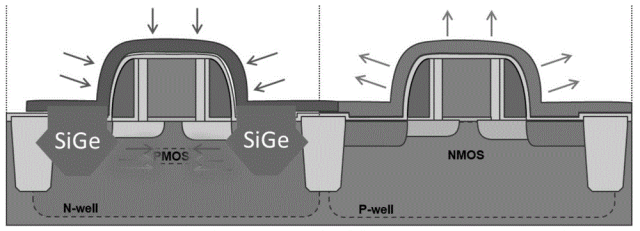
Свеобухватни ток процеса епитаксије СиГе
2.1 Предтретман:
Силицијумске плочице се претходно третирају на основу жељених исхода процеса, првенствено укључујући уклањање природног оксидног слоја и нечистоћа на површини вафла. За облатне подлоге са јаким допирањем, кључно је размотрити да ли је потребно заптивање да би се смањило аутоматско допирање током нареднихепитаксијски раст.
2.2 Гасови раста и услови:
Силицијумски гасови: Силан (СиХ₄), дихлоросилан (ДЦС, СиХ₂Цл₂) и трихлоросилан (ТЦС, СиХЦл₃) су три најчешће коришћена извора силицијумског гаса. СиХ₄ је погодан за процесе пуне епитаксије на ниским температурама, док се ТЦС, познат по брзој брзини раста, широко користи за припрему дебелихсилицијумска епитаксијаслојева.
Гас германијума: Германе (ГеХ₄) је примарни извор за додавање германијума, који се користи у комбинацији са изворима силицијума за формирање СиГе легура.
Селективна епитаксија: Селективни раст се постиже прилагођавањем релативних стопаепитаксијално таложењеи ин ситу јеткање, користећи ДЦС силицијум који садржи хлор. Селективност је због тога што је адсорпција атома Цл на површини силицијума мања од оне на оксидима или нитридима, што олакшава епитаксијални раст. СиХ4, без атома Цл и са малом енергијом активације, генерално се примењује само на процесе пуне епитаксије на ниској температури. Други уобичајено коришћени извор силицијума, ТЦС, има низак притисак паре и течан је на собној температури, што захтева да Х₂ мехуриће да би се увео у реакциону комору. Међутим, релативно је јефтин и често се користи због своје брзе стопе раста (до 5 μм/мин) за узгој дебљих слојева силицијумске епитаксије, који се широко примењују у производњи силицијумских епитаксијских плочица.
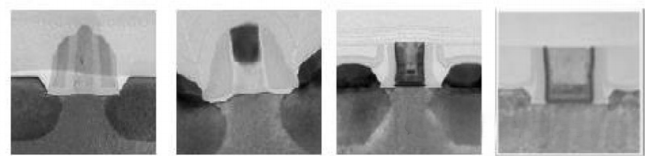
Напрегнути силицијум у епитаксијалним слојевима
Токомепитаксијални раст, епитаксијални монокристални Си се наноси на релаксирани слој СиГе. Због неусклађености решетке између Си и СиГе, монокристални слој Си је подвргнут затезном напрезању из доњег СиГе слоја, значајно повећавајући покретљивост електрона у НМОС транзисторима. Ова технологија не само да повећава струју засићења (Идсат) већ и побољшава брзину одзива уређаја. За ПМОС уређаје, СиГе слојеви се епитаксијално узгајају у регионима извора и одвода након јеткања да би се увео компресивни напон на канал, повећавајући покретљивост рупа и повећавајући струју засићења.
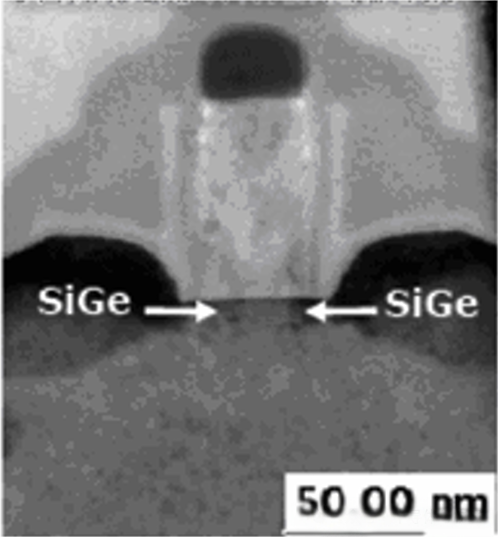
СиГе као жртвени слој у ГАА структурама
У производњи Гате-Алл-Ароунд (ГАА) наножичаних транзистора, СиГе слојеви делују као жртвовани слојеви. Технике анизотропног јеткања високе селективности, као што је квази-атомско нагризање (квази-АЛЕ), омогућавају прецизно уклањање СиГе слојева да би се формирале структуре наножица или нанолимова.
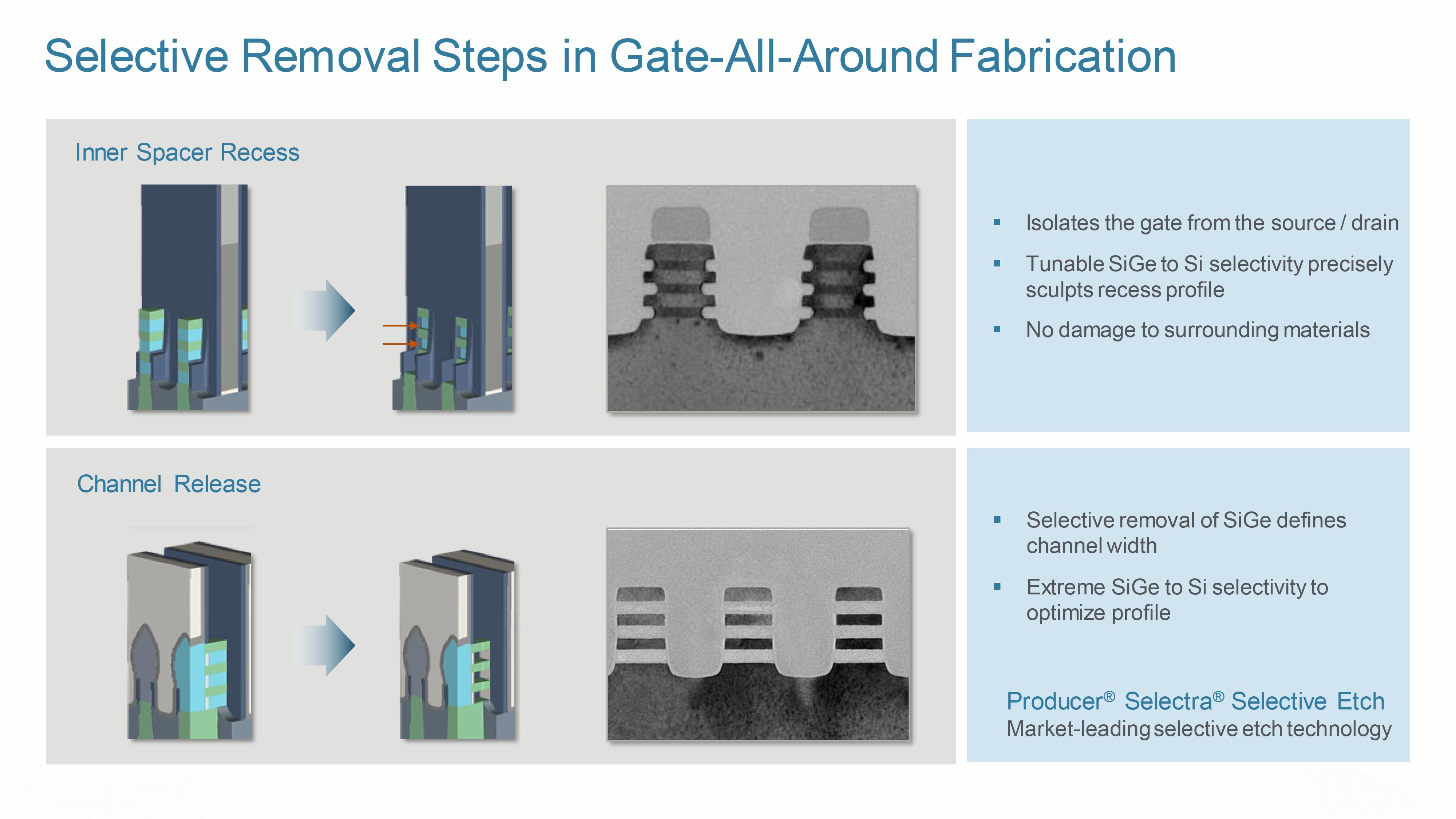
Ми у Семицорек-у смо специјализовани заГрафитни раствори обложени СиЦ/ТаЦпримењен у Си епитаксијалном расту у производњи полупроводника, ако имате било каквих питања или су вам потребни додатни детаљи, не оклевајте да нас контактирате.
Контакт телефон: +86-13567891907
Емаил: салес@семицорек.цом




