
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Дислокација у кристалима СиЦ
2023-08-21
СиЦ супстрат може имати микроскопске дефекте, као што су дислокација завртња са навојем (ТСД), дислокација ивице навоја (ТЕД), дислокација у основној равни (БПД) и други. Ови дефекти су узроковани одступањима у распореду атома на атомском нивоу.
Кристали СиЦ обично расту на начин који се протеже паралелно са ц-осом или под малим углом са њом, што значи да је ц-раван позната и као основна раван. Постоје две главне врсте дислокација у кристалу. Када је линија дислокације окомита на основну раван, кристал наслеђује дислокације из кристала семена у епитаксијално израстао кристал. Ове дислокације су познате као продорне дислокације и могу се категорисати у дислокације ивица са навојем (ТЕД) и дислокације навојних вијака (ТСД) на основу оријентације Бернулијевог вектора према дислокационој линији. Дислокације, где су и дислокацијске линије и Бронстедови вектори у основној равни, називају се дислокације основне равни (БПД). Кристали СиЦ такође могу имати композитне дислокације, које су комбинација горе наведених дислокација.
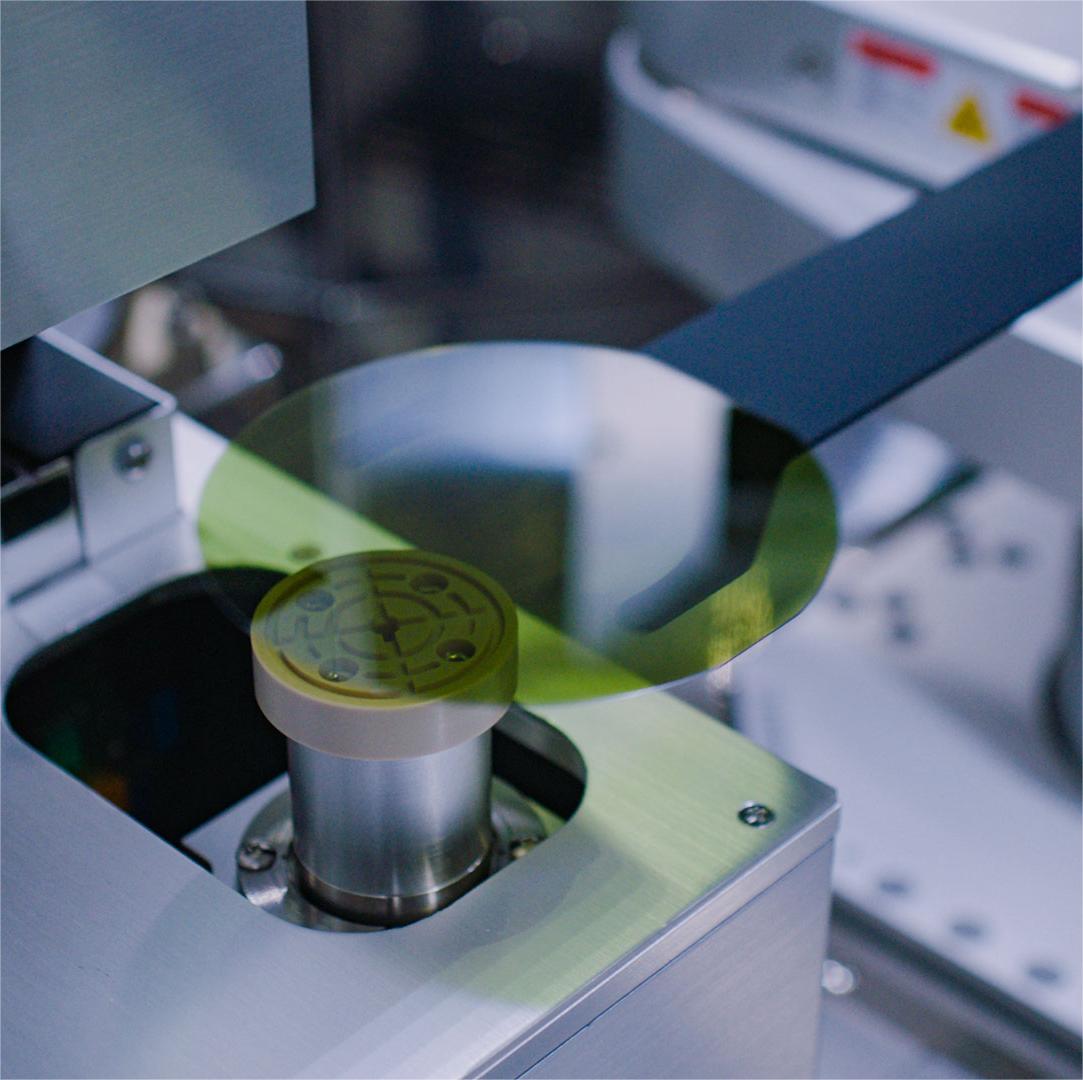
1. ТЕД&ТСД
И дислокације са навојем (ТСД) и дислокације са навојем (ТЕД) иду дуж [0001] осе раста са различитим Бургерсовим векторима од <0001> и 1/3<11-20>, респективно.
Both TSDs and TEDs can extend from the substrate to the wafer surface and produce small pit-like surface features. Typically, the density of TEDs is about 8,000-10,000 1/cm2, which is almost 10 times that of TSDs.
Током процеса епитаксијалног раста СиЦ, ТСД се протеже од супстрата до епитаксијалног слоја проширеног ТСД-а може се трансформисати у друге дефекте на равни супстрата и ширити се дуж осе раста.
Показало се да се током епитаксијалног раста СиЦ, ТСД трансформише у грешке слоја слагања (СФ) или дефекте шаргарепе на равни супстрата, док се показало да се ТЕД у епитаксијалном слоју трансформише из БПД наслеђеног од супстрата током епитаксијалног раста.
2. БПД
Дислокације базалне равни (БПД), које се налазе у равни [0001] СиЦ кристала, имају Бургерсов вектор од 1/3 <11-20>.
БПД се ретко појављују на површини СиЦ плочица. Они су обично концентрисани на подлози са густином од 1500 1/цм2, док је њихова густина у епитаксијалном слоју само око 10 1/цм2.
Подразумева се да се густина БПД смањује са повећањем дебљине СиЦ супстрата. Када се испитају помоћу фотолуминисценције (ПЛ), БПД показују линеарне карактеристике. Током процеса епитаксијалног раста СиЦ, продужени БПД се може трансформисати у СФ или ТЕД.
Из наведеног је евидентно да су дефекти присутни на плочици супстрата СиЦ. Ови дефекти могу бити наслеђени у епитаксијалном расту танких филмова, што може изазвати фатално оштећење СиЦ уређаја. Ово може довести до губитка предности СиЦ-а као што су велико поље квара, висок реверзни напон и ниска струја цурења. Штавише, ово може смањити стопу квалификације производа и представљати огромне препреке за индустријализацију СиЦ-а због смањене поузданости.




